显微红外光谱仪半导体行业表面异物分析——之辅料篇
1.为什么要进行表面异物分析
点击查看视频 ↓↓
关注半导体行业朋友可能都看过一类视频就是介绍如何把沙子变成芯片的介绍,从其描述中我们不难发现半导体产品制程很长,从最初的原材料到客户端的成品涉及到上百个工序和上千家供应商。半导体产品的制备除了具备高精度、先进的生产制造设备外,还需要关注在制造过程中所用到的原、辅料及生产环境。对于原辅料,一方面要求其性能参数满足生产要求,另一方面还需要关注原、辅料在生产过程可能存在的交叉污染问题。在生产使用过程中,产品表面往往容易被污染、腐蚀、氧化,或者由于生产缺陷、疏忽等原因引入和形成异物,增加了产品不良率,对产品的使用性能带来极大影响。异物的生成原因比较多,例如原材料不纯、反应有副产物、工艺控制不规范或工艺配方不成熟等。图1 为用于抛光晶片包装用圆盒及内表面粘附线状异物。
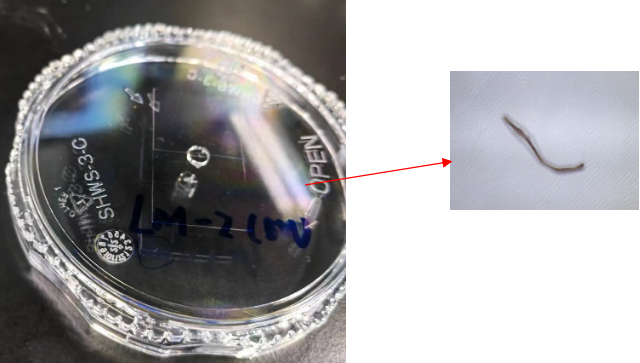
图1 晶圆包装圆盒内表面由线状异物
2.表面异物分析方案
方案一、如果待测异物是无机物,建议通过SEM-EDS或XRD或XRF及XPS等分析手段确定异物种类或物相等,图2分别为日立SEM-EDS、日本理学3KW XRD和波长色散型XRF产品实物图片;

图2 从左至右依次为日立SU8600 FE-SEM[1],日本理学 Smartlab XRD和ZSX Primus IV[2]
方案二、如果待测异物是有机物,建议通过显微红外、纳米红外或显微共聚焦拉曼等成像技术实现异物的原位分析。图3[3]分别为布鲁克显微红外,纳米红外和显微共聚焦拉曼产品实物图片。

图3 上起、左起依次布鲁克显微红外Lumos II,纳米红外Dimension Icon IR和显微共聚焦拉曼Senterra II
3.显微红外异物分析案例
| Lumos II测试条件 · 分辨率:4cm-1 · 扫描次数:32次 · 波数范围:4000-650cm-1 · 测试方法:Ge晶体ATR · 检测器:液氮制冷MCT检测器 |  |
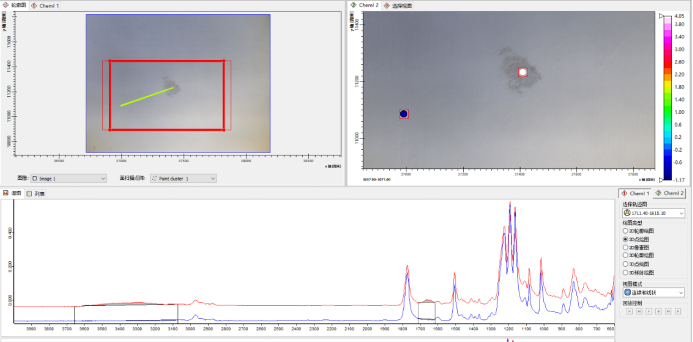
图4为晶圆包装盒内部异物点红外分析界面
从图4左上角可见光照片上可以看到异物是呈薄膜状附着在圆盒内表面,尺寸约170x120um。利用Lumos II 同轴光路高精度ATR分别测量圆盒干净区域和污染区域,对应红外谱图见图4,其中蓝色谱图是圆盒本体,红色谱图是异物点。由于异物点为微米级别的薄膜,所以异物点的红外谱图是圆盒本体和异物点谱图的叠加,其中在3700-3100cm-1和1700-1600cm-1波数范围内有明显差异。利用布鲁克OPUS红外软件谱图差减功能可以得到异物点的红外谱图(红色),利用软件自带谱库进行检索,异物点与毛织物谱图(绿色)比较相近,见图5。可以排除异物来自于包装盒和晶圆本体。结合生产工序所涉及的辅料,推测该异物来自无尘棉,见图6。
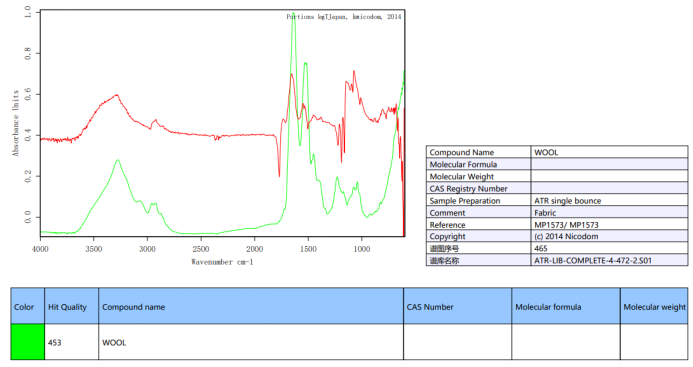
图5 异物点差谱谱图

图6 无尘棉及对应谱图
北京实验室有Lumos II样机,欢迎感兴趣的客户提供样品亲自上机操作体验
注:
[1] https://www.hitachi-hightech.com/cn/
